CMP 全稱為 Chemical Mechanical Polishing,即化學機械拋光,是機械削磨和化學腐蝕的組合技術,借助超微離子研磨作用以及漿料的化學腐蝕作用在被研磨的介質表面上形成光潔的平面。
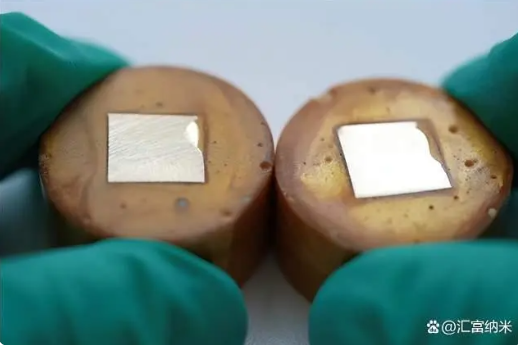
在傳統拋光方法中,機械拋光研磨一致性好,表面平整度高,研磨效率高容易出現表面層損傷,表面粗糙度比較高;化學拋光表面精度高、損傷低、完整性好,不容易出現表面損傷,但研磨速率較慢,材料去除效率較低,不能修正表面精度,研磨一致性比較差。而化學機械拋光采用機械摩擦與化學腐蝕相結合的工藝,二者交替進行,最終完成工件的拋光,速率慢者控制拋光的速率。

化學機械拋光的優點主要是:可以獲得全局平坦化能平坦化所有類型材料的表面;能平坦化多層材料的表面;可以降低由于設計尺寸的減小和布線層數的增多而導致的對薄膜形貌的苛刻要求;避免了對難以刻蝕的金屬或合金所需要的反應離子刻蝕RIE和等離子刻蝕;能夠減小材料表面起伏;能夠提高0.25um及以下器件和電路的可靠性、速度和成品率;改善材料的臺階覆蓋率和去除材料的表面缺陷。
拋光液是影響化學機械拋光質量和拋光效率的關鍵因素,一般通過測定材料去除率和表面粗糙度的方法來評價拋光液性能優良程度。其組分包括磨料、氧化劑和其他添加劑,通常根據被拋光材料的物理化學性質及對拋光性能的要求,選擇合適的拋光液。
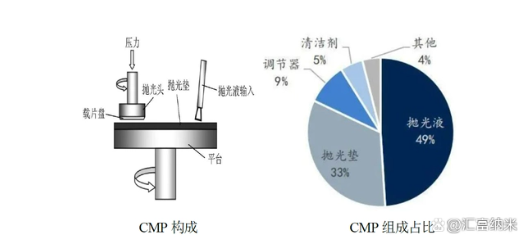
磨料是拋光液最主要的組成部分,在拋光工程中通過微切削,微擦劃和滾壓等方式作用于被加工材料表面,達到機械去除材料的作用。根據磨料的不同又可分為單一磨料拋光液,混合磨料拋光液和復合磨料拋光液。


 手機資訊
手機資訊 官方微信
官方微信








 豫公網安備41019702003604號
豫公網安備41019702003604號