隨著半導體產業的迅猛發展,金剛石因其優異的導熱性能、超寬的禁帶結構以及較高的載流子遷移率,逐漸成為業界備受矚目的半導體材料之一。然而,金剛石的加工難度一直是制約其廣泛應用的關鍵因素。
近日,大族半導體在金剛石切片領域取得了重要的技術突破,推出了QCBD激光切片技術及其相關設備,實現了金剛石高質量低損傷高效率激光切片。這一成果標志著激光切片技術在金剛石材料加工中取得重要進展,填補了國內在該領域的技術空白。
通過對激光能量的精確調控與光束形態的調制,大族半導體克服了金剛石解理面{111}與切片方向{100}之間較大角度帶來的加工難題,實現了晶錠的高精度、低損傷剝離。根據大族半導體QCB研究實驗室研究數據顯示,使用該技術,剝離后粗糙度Ra低至3μm以內,激光損傷層可大幅度降低至20μm。這項技術突破將大幅降低金剛石的加工成本,推動其在電子、光學等高端領域的廣泛應用。
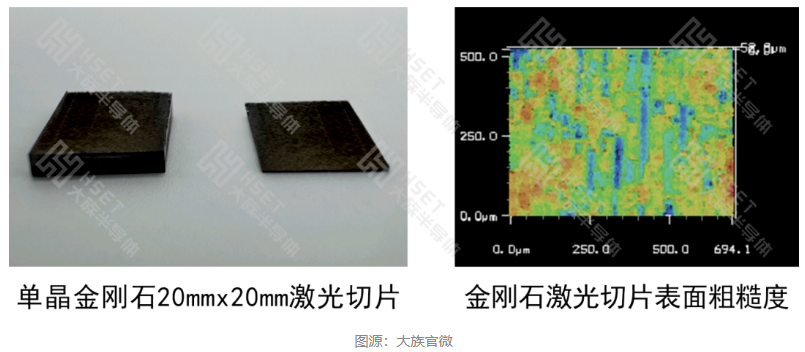
大族半導體研發的金剛石激光切片技術,憑借卓越的加工效能,已成功攻克半導體材料加工技術領域的眾多棘手難題。這一技術的突破,不僅顯著加速了生產流程,將生產效率推向新高,而且精細入微的工藝確保了產品質量的飛躍式提升,同時,通過優化生產流程,有效降低了制造成本,展現出了極為廣闊的市場應用前景,預示著其在未來的高科技制造領域中必將占據舉足輕重的地位,引領半導體材料加工技術邁向一個全新的發展階段。


 手機資訊
手機資訊 官方微信
官方微信








 豫公網安備41019702003604號
豫公網安備41019702003604號