3月3日,華為用于芯片散熱的兩項復合導熱材料專利公布。專利說明書顯示,兩項專利以不同的技術方案獲取芯片散熱的復合導熱材料,其中一個技術方案以鐵磁性顆粒材料作為導熱填料;另一個技術方案則以金剛石顆粒材料為主要散熱材料。兩個技術方案經實驗驗證,較傳統硅脂等界面導熱材料的導熱性能,有大幅度的提升。可廣泛適用于,手機、電腦、服務器等電子設備中。

據悉,電子設備中的發熱功率器件,如芯片,產生的熱量通常需借助散熱器實現熱量向外部擴散。從微觀角度看,芯片與散熱器的接觸界面為凹凸不平的,通常使用界面導熱材料填充在芯片與散熱器之間,降低接觸熱阻。界面導熱材料通常包含導熱硅脂、導熱墊、導熱凝膠、相變導熱材料、導熱膠等;且根據不同的應用場景,可使用不同類型、不同導熱系數的界面導熱材料。但面對電子設備性能的不斷提升,發熱功率器件產生的熱量也不斷提高,就需要導熱系數更高的界面導熱材料。
詳情



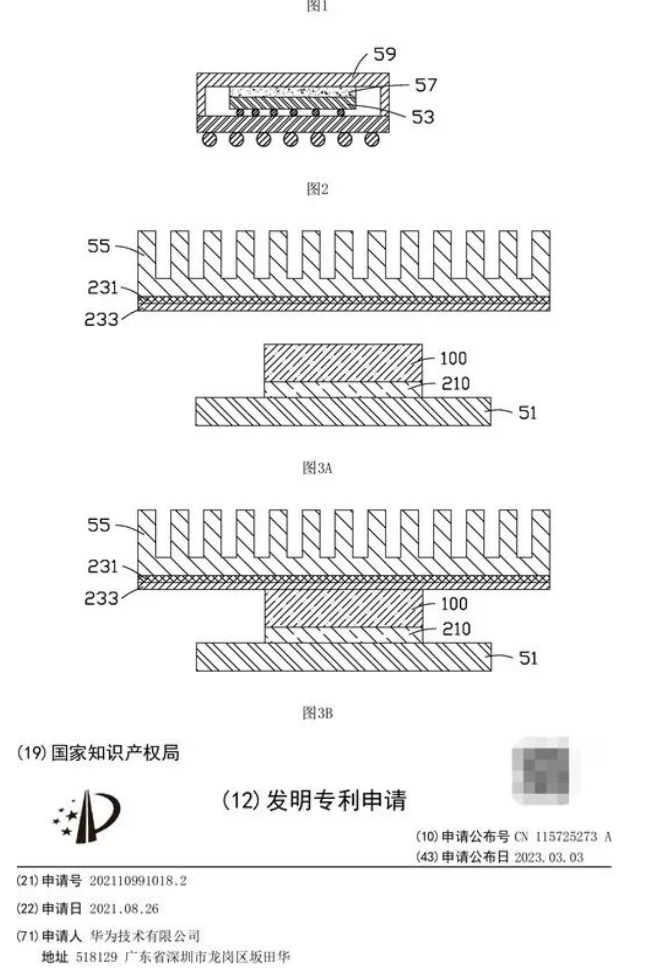


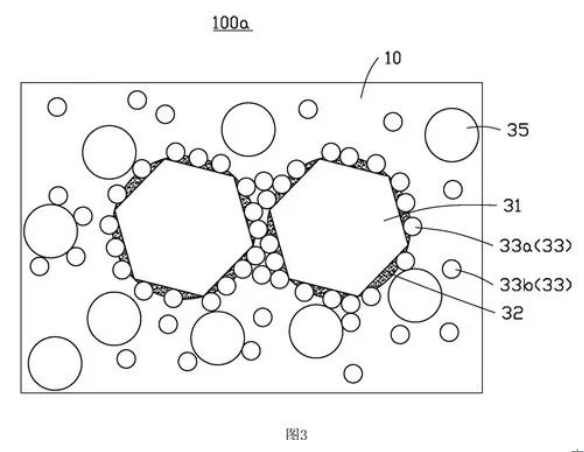


 手機資訊
手機資訊 官方微信
官方微信








 豫公網安備41019702003604號
豫公網安備41019702003604號